 |
АвтоАвтоматизацияАрхитектураАстрономияАудитБиологияБухгалтерияВоенное делоГенетикаГеографияГеологияГосударствоДомДругоеЖурналистика и СМИИзобретательствоИностранные языкиИнформатикаИскусствоИсторияКомпьютерыКулинарияКультураЛексикологияЛитератураЛогикаМаркетингМатематикаМашиностроениеМедицинаМенеджментМеталлы и СваркаМеханикаМузыкаНаселениеОбразованиеОхрана безопасности жизниОхрана ТрудаПедагогикаПолитикаПравоПриборостроениеПрограммированиеПроизводствоПромышленностьПсихологияРадиоРегилияСвязьСоциологияСпортСтандартизацияСтроительствоТехнологииТорговляТуризмФизикаФизиологияФилософияФинансыХимияХозяйствоЦеннообразованиеЧерчениеЭкологияЭконометрикаЭкономикаЭлектроникаЮриспунденкция
Легирование полупроводниковых
материалов. Получение p–n переходов
Цель лекции – ознакомление с основными методами введения регулируемого количества примесей в твердые тела (вплавление, диффузия, ионная имплантация), способами управления профилем распределения атомов примеси и получения p–n- переходов.
Введение примеси (легирование) возможно как в процессах выращивания монокристаллов, пленок, поликристаллических твердых тел, так и после их получения - в готовые кристаллы, пленки, слитки. Последнее необходимо для модифицирования состава и свойств приповерхностных слоев твердых тел, а также для получения p–n- переходов в монокристаллах полупроводников. Способы введения примесей в процессах выращивания монокристаллов и пленок описаны выше. Здесь рассмотрим три основных метода легирования готовых кристаллов: вплавление, диффузию и ионную имплантацию.
Вплавление. При вплавлении материал примеси (как правило, легирующий металл, например индий в германии, алюминий в кремнии) в форме таблетки помещают на тщательно очищенную поверхность полупроводникового кристалла. Систему металл–полупроводник разогревают до температуры, равной или немного превышающей Т пл эвтектики, но значительно более низкой, чем T пл полупроводника. Примесь понижает температуру плавления, и поэтому в месте контакта образуется расплав. В него диффундируют атомы примеси. Регулируя температуру в системе и массу взятой таблетки, можно варьировать концентрацию примеси в получившемся расплаве и глубину распространения расплавленной зоны, т. е. будущего p – n- перехода. Для ограничения площади растекающегося расплава используют графитовые кассеты или нанесение масок из несмачиваемого расплавом вещества. Затем систему медленно охлаждают для рекристаллизации расплава, в процессе чего восстанавливается монокристаллическая область. При неполном плавлении таблетки после кристаллизации одновременно с p – n- переходом формируется и электрод, необходимый для электроконтакта с рекристаллизованной областью. Глубина вплавления (или толщина рекристаллизованного слоя) определяется по формуле
x = (h d M sП МП):[ d П(1-sП) MМ], (20.1)
где h - высота таблетки, d M и d Пплотности металла и полупроводника, MМ и МП - их атомные массы, sП – растворимость полупроводника в расплаве металла.
Диффузия. Для легирования твердых тел методом диффузии необходим разогрев до достаточно высоких температур, при которых очень медленный процесс диффузии может протекать с ощутимой скоростью. Такие температуры превышают половину T пл (К), которую называют температурой Таммана. Диффузия атомов примеси в твердых телах может протекать либо по междоузлиям, если диффундирующие атомы малы и могут там поместиться, либо по дефектам – вакансиям, где в узлах кристаллической решетки отсутствуют атомы (рис. 20.1 а и 20.1 б соответственно). Механизм одновременного перескока соседних атомов обменивающихся местами (рис. 20.1 в), менее вероятен. Из схем видно, какую большую роль в скорости диффузии играет соотношение размеров и химических свойств диффундирующих атомов (диффузанта) и легируемых кристаллов.

а б в
Рис. 20.1. Схемы диффузионных перемещений атомов примеси:
а - по междоузлиям, б - по вакансиям, с - кольцевой обмен
Скорость диффузии определяется коэффициентом диффузии (D), зависящим от природы веществ и температуры. Для управления количеством примеси и глубиной p – n- перехода диффузию проводят в два этапа. На первом введение в легируемое твердое тело нужного количества примеси Q достигают, используя источник неограниченной мощности и регулируя температуру и длительность процесса (стадия загонки). На втором этапе задают нужный профиль распределения концентрации примеси в приповерхностном слое образцов, что обеспечивают путем перераспределения атомов примеси, находящихся вблизи поверхности, вглубь. Профиль распределения также регулируется путем варьирования времени и температуры процесса. Эту стадию процесса легирования называют разгонкой. Профили распределения примесей при легировании вплавлением и диффузией представлены на рис. 20.2.

Рис. 20.2. Профили распределения примесей в
кристаллах после легирования методами:
1 - вплавления; 2 - диффузии (после стадии «загонки» примеси из
источника неограниченной мощности); 3 - ионной имплантации
(h - глубина нахождения примеси в кристалле, N - концентрация
примеси, N0 - концентрация примеси до легирования,
h1, h2 и h3глубина залегания p-n- перехода)
Форма профиля распределения примеси после стадий загонки и разгонки различается: после первой стадии кривая зависимости «концентрация примеси - расстояние от поверхности кристалла» более вогнутая (описывается первым законом Фика); после второй стадии имеет меньшую кривизну (описывается вторым законом Фика), поскольку распределение примеси на второй стадии выравнивается.
Если источник диффузанта имеет неограниченную мощность, то за время проведения процесса (t) поток диффузанта (J) остается постоянным. Диффузия обусловлена градиентом концентрации диффундирующего вещества (¶ N/ ¶ x). Математически такую зависимость описывает первый закон Фика. Согласно ему, когда концентрация вещества изменяется лишь в направлении оси x, выражение для потока диффундирующего вещества имеет вид:
J (x) = – D (¶ N/ ¶ x). (20.2)
Масса введенной примеси, определяемая первым законом Фика, пропорциональна  .
.
В случае, когда источник диффузанта ограничен, поток диффундирующих атомов постепенно ослабевает. Этот случай описывается вторым законом Фика
¶ N/ ¶ t = – ¶ J/ ¶ x. (20.3)
Пользуясь математическим аппаратом, на основании второго закона Фика можно рассчитать глубину проникновения примеси и глубину залегания p–n- перехода, которая пропорциональна  .
.
Наиболее часто диффузию проводят методом открытой трубы. Для этого легируемые монокристаллы полупроводника помещают в кварцевую трубу, через которую при подогреве до 1100–1200 оС прокачивают находящийся в газообразном состоянии диффузант в потоке инертного газа-носителя. Источниками донорных примесей в кремнии, германии являются хлорид и бромид фосфора (III), оксохлорид фосфора (V), реже - фосфин и арсин, оксиды фосфора и мышьяка, гидро- и дигидрофосфаты. Источники акцепторных примесей - это BCl3, Ga2O3, Al. При диффузии имеют место не только физические, но и химические процессы на поверхности кристаллов:
2P2O5 + 5Si = 4P + 5SiO2 (20.4)
m SiO2 + n P2O5 = n P2O5 · m SiO2 (20.5)
2BCl3 + 3O2 + 3H2 = B2O3 + 3HCl (20.6)
Si + O2 = SiO2 (20.7)
m SiO2 + n B2O3 = n B2O3· m SiO2 (20.8)
Отметим, что n P2O5 · m SiO2 и n B2O3· m SiO2 - фосфорсиликатное и борсиликатное стекла (ФСС и БСС), образующие пленки на поверхности кристалла кремния, являются источниками фосфора и бора на второй стадии диффузии, которую проводят при более высокой температуре. Формирование оксида кремния предохраняет поверхность кремниевых пластин от эрозии. После окончания процесса диффузии образующийся на поверхности стеклообразный слой стравливают.
Диффузия атомов примесей сквозь пленку SiO2, получаемую при термическом окислении кремния, протекает очень медленно (мал коэффициент диффузии). Этим пользуются для проведения локальной диффузии, когда основная часть поверхности кремния защищена маской из SiO2, а воздействию диффузанта подвергаются лишь открытые участки с заданными формой и размерами.
Ионная имплантация. Ионное легирование – это управляемое введение атомов в приповерхностный слой подложки путем бомбардировки ионами с энергией от нескольких килоэлектронвольт до нескольких мегаэлектрон-вольт (20–100 кэВ или 0,003–0,16 пДж). Идея управляемого ионного легирования полупроводников была выдвинута одновременно А. Ф. Иоффе (СССР) и У. Шокли (США) в 50-х годах XX века, однако только в 1962–1964 гг. эту идею удалось воплотить на практике и получить высококачественные р – n- переходы.
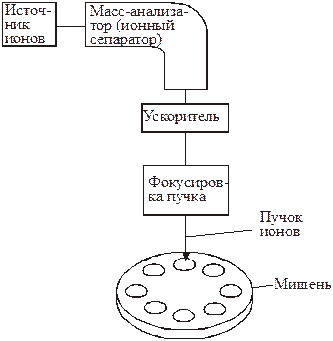
Рис. 20.3. Схема установки для ионного внедрения
В установке для ионного легирования (рис. 20.3) атомы легирующего вещества под действием мощного электрического поля ионизируются и приобретают направленное движение. Энергия ионов определяется ускоряющим напряжением и кратностью ионизации. Пучок ускоренных ионов поступает в масс-сепаратор, где под действием сильного магнитного поля ионы разделяются по массам. Имеется возможность выделения строго одного сорта атомов, что позволяет сэкономить затраты на очистку легирующих веществ. В отличие от процессов диффузии и вплавления, которые являются равновесными и позволяют получать только термодинамически стабильные твердые растворы, при ионной имплантации возможно введение в приповерхностный слой любых примесей и в любых неравновесных концентрациях. Таким способом можно получать не только твердые растворы, но и разнообразные химические соединения (например нитриды, карбиды кремния) при низких температурах.
В результате внедрения в приповерхностный слой атомов примеси образуется множество дефектов. При большой концентрации примеси образуется аморфная область. Для восстановления совершенства кристаллической решетки легированные кристаллы подвергают отжигу при температурах 400–800 оС, что значительно ниже, чем в процессах диффузии.
Количество внедренной примеси регулируют, варьируя плотность ионного тока и длительность процесса имплантации. Глубина проникновения примеси в кристалл определяется энергией легирующих ионов, которые, соударяясь с атомами или ионами в кристаллической решетке, прекращают движение после нескольких столкновений и остаются внедренными в твердое тело. Энергия ионов, а следовательно, и число столкновений до полного торможения определяются, главным образом, ускоряющим напряжением, хотя имеются и другие факторы, влияющие на глубину проникновения ионов и профиль распределения примеси. Так, движение ионов может происходить вдоль плоскостей кристаллической решетки (эффект каналирования). В таком случае пробег ионов в кристалле непредсказуемо увеличивается, что затрудняет расчет профиля распределения примеси и глубины р – n- перехода. Чтобы не допустить каналирования, кристалл ориентируют под небольшим углом относительно пучка ионов.
Профиль распределения атомов примеси в приповерхностном слое в отсутствие эффекта каналирования описывается гауссовой кривой (см. рис. 20.2). Характерной особенностью ионного легирования является малая глубина проникновения примеси, обычно не превышающая десятых долей микрона. Для сравнения глубина проникновения примеси при диффузионном легировании достигает 10-20 мкм. Предельная глубина проникновения имплантируемых атомов примеси определяется мощностью используемых установок. В полупроводниковой технике легирование используют для получения p – n- переходов, т. е. создания границ, по обе стороны которых находятся области кристаллов с разным типом проводимости. На рис. 20.2 p – n- переходы расположены на расстоянии h от поверхности кристаллов, на котором концентрация исходной примеси равна концентрации примеси, введенной при легировании и обеспечивающей проводимость противоположного типа.
Можно использовать различные комбинации указанных методов легирования. Например, обогащенный примесью слой наносят на поверхность кристалла осаждением из раствора, а затем систему прогревают для перераспределения примеси вглубь. Такое многообразие позволяет варьировать природу и профиль распределения атомов примеси.
Заключение
Поиск по сайту: